X射线检测BGA焊点:穿透封装,消除隐患
BGA封装焊点隐藏于封装体之下,肉眼与AOI均无从查验——X-Ray能够对BGA进行可靠无损检测的技术手段。
BGA封装是什么?为何检测如此困难?
BGA(Ball Grid Array,球栅阵列封装)是一种将芯片焊球排列在封装底部的高密度封装形式,广泛应用于CPU、GPU、内存、通信模组等高性能器件。与传统QFP封装不同,BGA的焊点完全藏匿于封装体正下方,常规光学检测(AOI)或人工目检无法看到任何焊接信息。
随着电子产品趋向小型化、高频化,BGA封装的引脚间距不断缩小(最小可达0.3mm),焊点数量从几十颗增至数百甚至上千颗。一旦发生焊接缺陷,在PCBA上电前几乎无法察觉,而等到功能测试发现问题时,产品往往已流入下道工序甚至终端客户手中,维修成本呈几何级数攀升。
据行业统计,BGA焊接缺陷若在流水线阶段即时发现,修复成本不足出货后召回成本的 1/100。X射线检测正是将缺陷拦截在出厂前最有效的质检手段。
X射线下的BGA:焊点无所遁形
下图为通过X射线检测设备对BGA器件实际采集的X-Ray透视图像,可清晰呈现每颗焊球的形态、内部气孔分布及连接状态,为工艺工程师提供准确的分析依据。
 BGA焊点X-Ray透视图像 — 气泡与连接状态清晰可见
BGA焊点X-Ray透视图像 — 气泡与连接状态清晰可见X射线能检出哪些BGA焊接缺陷?
以下六类缺陷是BGA生产中最常见也最具隐蔽性的问题,传统检测方式几乎无能为力,X射线均可精准识别:
焊球与焊盘未完全熔合,电气连接不可靠,是导致产品间歇性失效的主要原因。
焊点内部存在孔洞(Voiding),导致导热性差、通流能力下降,高频应用中尤为敏感。
相邻焊球因锡膏过量或回流不当发生连接,产生短路隐患。
部分引脚焊球完全缺失,电路开路,X-Ray灰度图一目了然。
焊球对位偏差超出允许范围,长期振动或热循环后易发生开裂。
焊球因过热或机械应力导致形态异常,X射线可测量实际球高与形状偏差。
X-Ray 与其他检测方式对比
面对BGA封装的检测挑战,各类检测方法的能力差异十分显著:
| 检测方式 | BGA焊点可见性 | 缺陷检出率 | 是否破坏样品 | 适用场景 |
|---|---|---|---|---|
| X射线 (X-Ray) | 完整透视 ✔ | ≥99% ✔ | 否(非破坏)✔ | 量产质检 / 研发分析 |
| AOI 自动光学检测 | 无法检测 ✗ | 0%(BGA区域)✗ | 否 | 表面缺陷(非BGA) |
| 人工目检 | 不可见 ✗ | 极低 ✗ | 否 | 简单外观检查 |
| 切片分析(金相) | 截面可见 ✔ | 高 ✔ | 是(破坏样品)✗ | 失效分析 / 实验室 |
| ICT 在线测试 | 无法判断形态 | 可检测开短路 | 否 | 电气连通性验证 |
X射线检测BGA的工作原理
X射线穿透PCBA板时,密度越高的物质(如锡球)对X射线的吸收越强,在成像平面上表现为更深的灰度阴影。通过分析每颗BGA焊球的灰度形态、面积及内部结构,系统可自动或辅助工程师判断焊接质量。
将待检PCBA放入X射线检测设备检测区,支持单板、拼板或托盘上料,无需拆解组件。
X射线管发射射线穿透PCBA,探测器接收信号并实时生成高分辨率灰度图像,BGA焊球逐一呈现。
通过多角度倾斜成像(2D/2.5D/3D CT),可区分上下层焊球,准确识别堆叠焊点内部缺陷。
配套检测软件自动标注异常焊点,计算气孔率、焊球直径偏差等量化参数,生成检测报告。
PASS/FAIL结果自动记录,支持与MES/SPC系统对接,实现产品批次追溯与工艺改善闭环。
选择专业X射线检测设备的核心优势
高分辨率平板探测器与微焦点X射线管配合,可清晰分辨间距仅0.3mm的BGA焊球,细小气泡、裂纹均无处遁形。
支持SMT产线在线集成(AXI)或独立离线检测(Offline X-Ray),可按产能与场地灵活配置,满足研发与量产双重需求。
符合国际辐射安全标准,全封闭铅屏蔽机柜,设备外辐射剂量远低于安全阈值,操作人员与产品均安全无虞。
先进算法自动标记疑似缺陷区域,降低人工判读负担,减少漏判与误判,有效提升检测一致性与效率。
除BGA外,同样适用于CSP、QFN、LGA、FC(倒装芯片)、THT插件焊接及锂电池内部结构检测,一台设备多场景覆盖。
自动生成焊点气孔率、焊球尺寸偏差、Pass/Fail统计报表,数据可导出用于SPC分析与工艺改善,打通质量管控闭环。
哪些行业最需要X射线检测BGA?
消费电子 / 手机制造:智能手机主板BGA封装密度极高,任何虚焊都可能导致信号中断或无线功能失效,X-Ray是出货前的最后防线。
汽车电子:车规级电子产品需满足AEC-Q100等严苛可靠性标准,BGA焊点在宽温、振动环境下的长期可靠性必须通过X-Ray提前验证。
通信设备 / 5G基站:高频信号对焊接质量极为敏感,气孔与冷焊会导致阻抗异常,影响信号完整性,X射线检测是5G PCBA品控标配。
航空航天 / 医疗器械:对产品可靠性要求达到零容忍级别,X射线检测是质量体系认证(DO-254、ISO 13485等)的必要环节。
SMT代工厂 / EMS服务商:承接多品类客户板件,X-Ray检测能力是拓展高端客户、提升报价竞争力的核心资质之一。








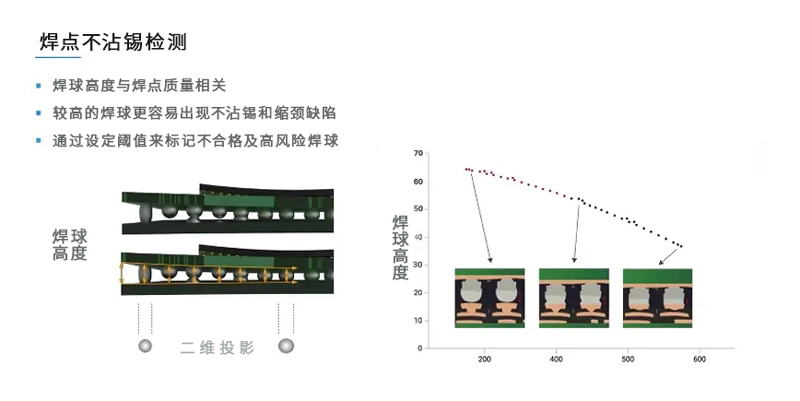





 总部地址:深圳市光明区马田街道星源先进材料产业园3栋7楼
总部地址:深圳市光明区马田街道星源先进材料产业园3栋7楼  袁经理:
袁经理:
