X-RAY检测BGA气泡空洞的意义
文章来源:骅飞科技X-Ray 发布时间: 2024-04-23
随着电子产品的科技化与精密化,越来越多的企业注重产品品质,特别是一直以来电子产品经常容易出现接触不良的问题,导致品质管控迫在眉睫,为此,越来越多的企业力争把细节做到极致,其中SMT就是其中非常关键的一环。
X射线检测BGA(Ball Grid Array)气泡的主要目的是确保电子器件的质量和可靠性。
气泡在BGA焊接点下方形成可能会导致以下问题:
- 1. 焊接质量问题: 气泡可能会影响焊料的润湿性,导致焊料无法充分润湿焊接表面,从而影响焊接质量。这可能会导致焊接不牢固,从而影响电子器件的性能和可靠性。
- 2. 电气连接问题:*气泡可能会导致焊接点的电气连接不良或间歇性连接,从而影响电子器件的功能。这可能会导致信号传输中断、电气性能下降或设备故障。
通过X射线检测BGA气泡,可以及时发现并评估气泡的大小、分布和位置,从而及时采取措施解决问题。这有助于确保BGA焊接的质量和可靠性,提高电子产品的性能和寿命,同时降低了因焊接问题而导致的维修成本和生产损失。
BGA(Ball Grid Array)是一种常见的封装技术,而气泡空洞可能会在其焊点下方形成,这可能会导致焊接不良或电气连接问题。X射线检测(X-Ray Inspection)是一种常用的方法,用于检测BGA连接是否存在气泡空洞。在X射线检测中,X射线透过BGA组件,而气泡空洞会产生与周围材料不同的密度,因此在X射线成像中会显现出来。这种方法可以有效地检测出BGA连接中的气泡空洞,确保焊接质量和电气连接的可靠性。
骅飞科技,工业X-Ray智能检测装备的制造商。
回到顶部








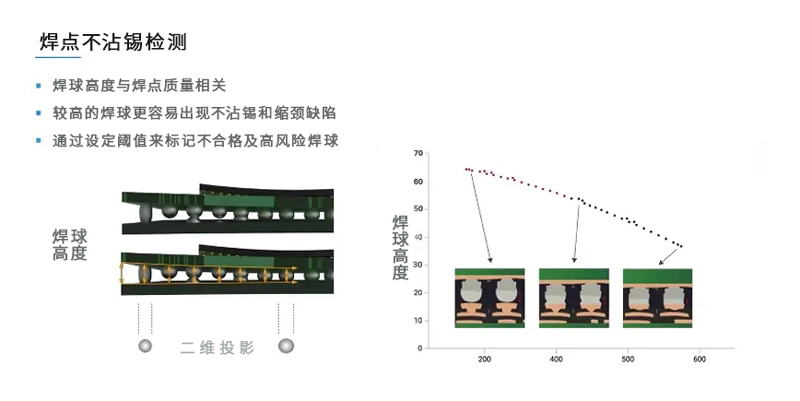





 总部地址:深圳市光明区马田街道星源先进材料产业园3栋7楼
总部地址:深圳市光明区马田街道星源先进材料产业园3栋7楼  袁经理:
袁经理:
