骅飞科技 AXI 3D 在线平面 CT 检测系统
突破传统检测极限。通过 360° 环形运动采集与实时三维重建技术,为 PCB、半导体及新能源电池提供微米级、无损的内部缺陷透视方案。
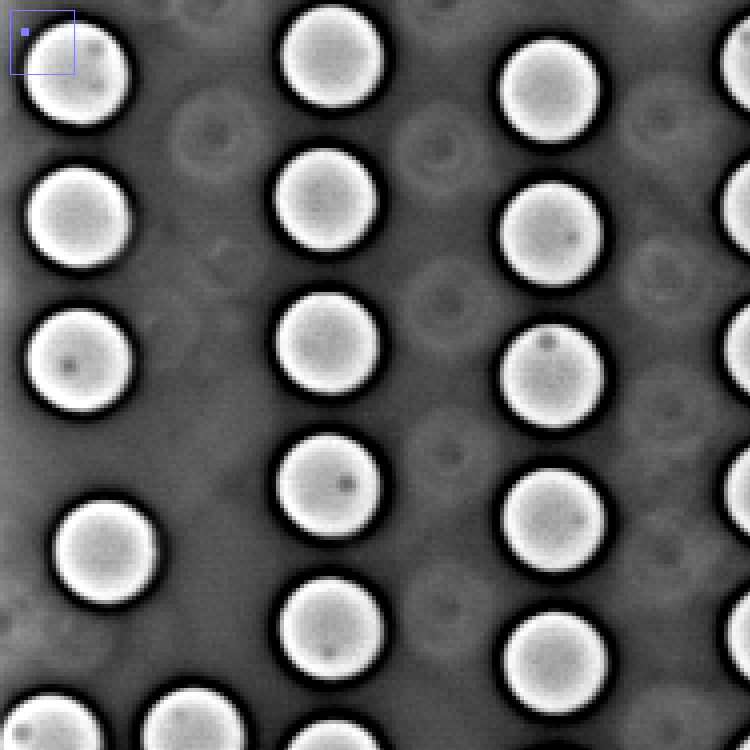
BGA 局部微米级放大

BGA 整体透视视图
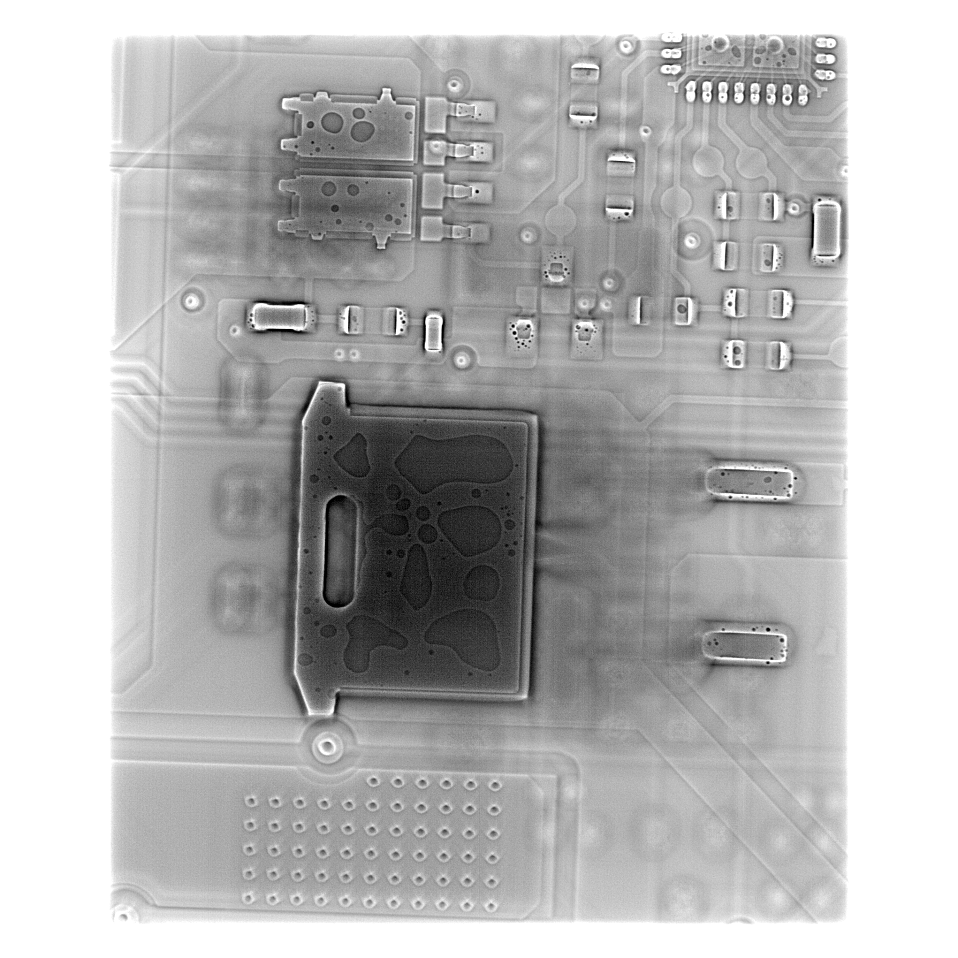
内部气孔着色分析

TGV 通孔缺陷检测
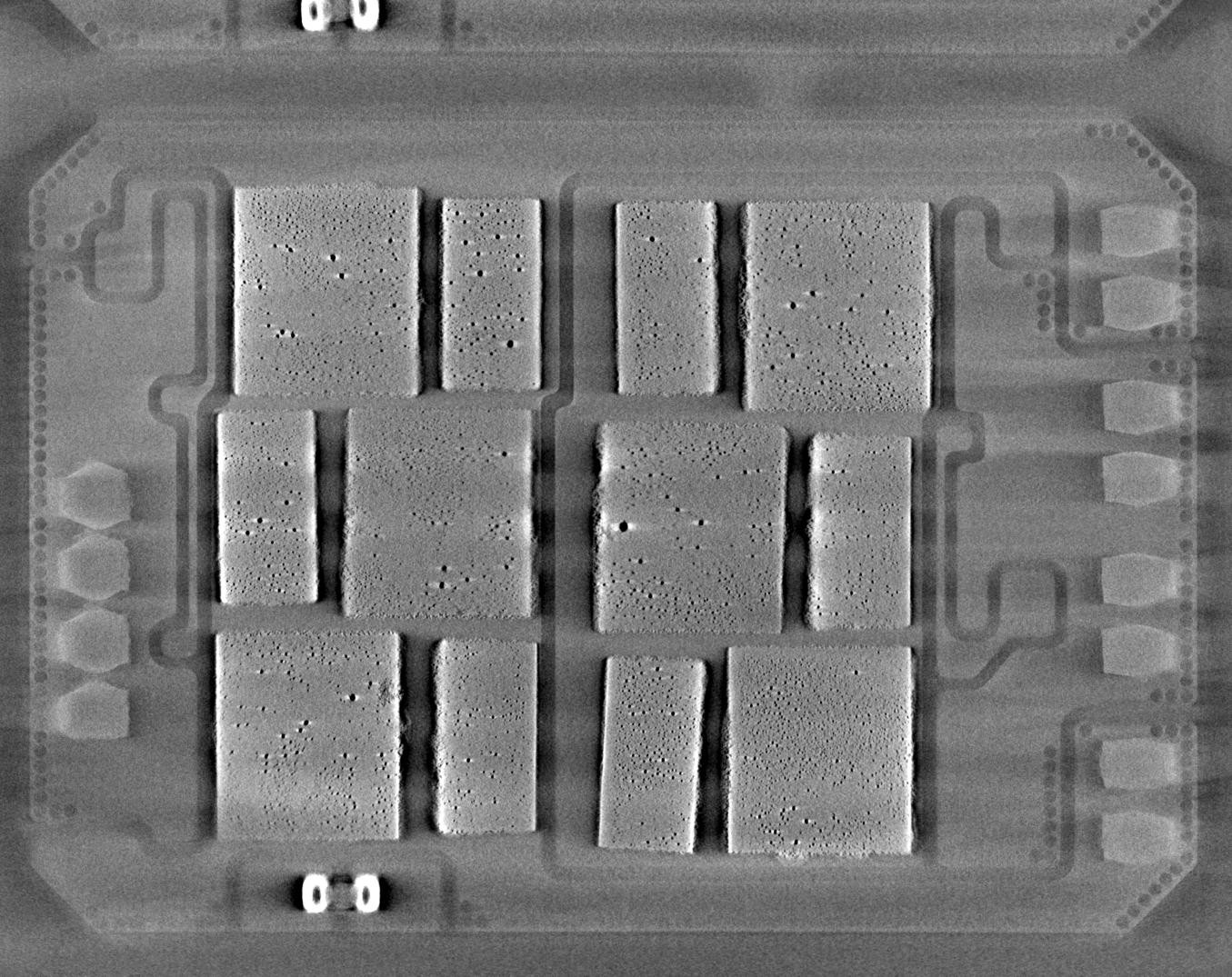
IGBT 功率器件检测

锂电铜极耳翻折

锂电铝极耳开裂
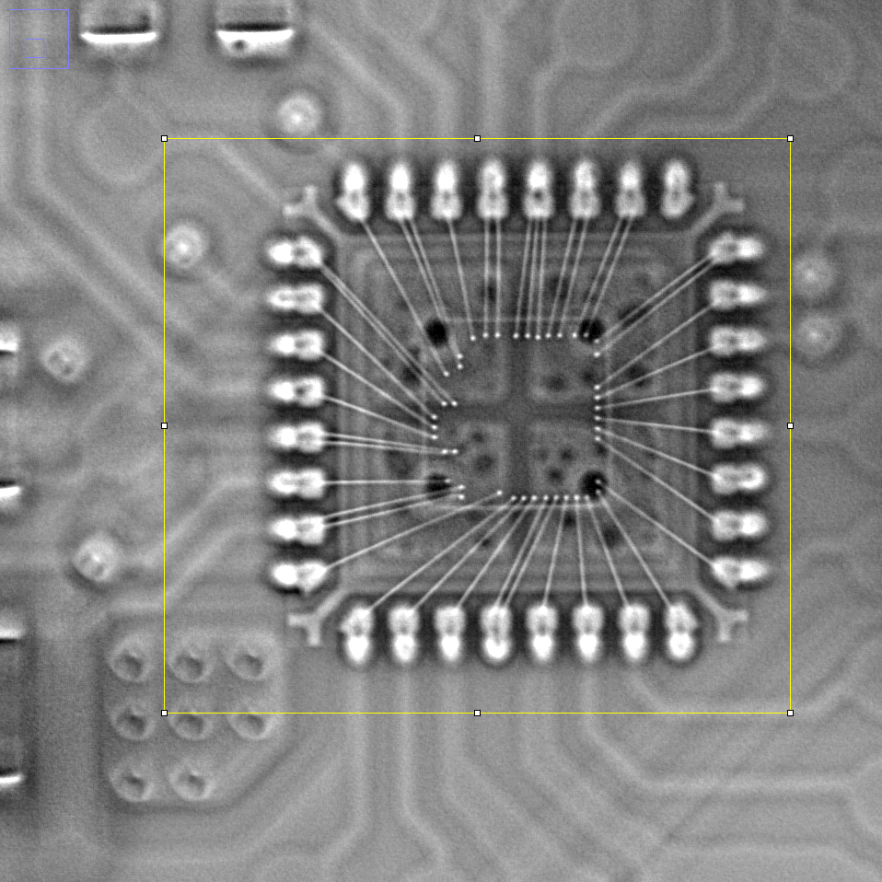
SMT 焊点气孔分析
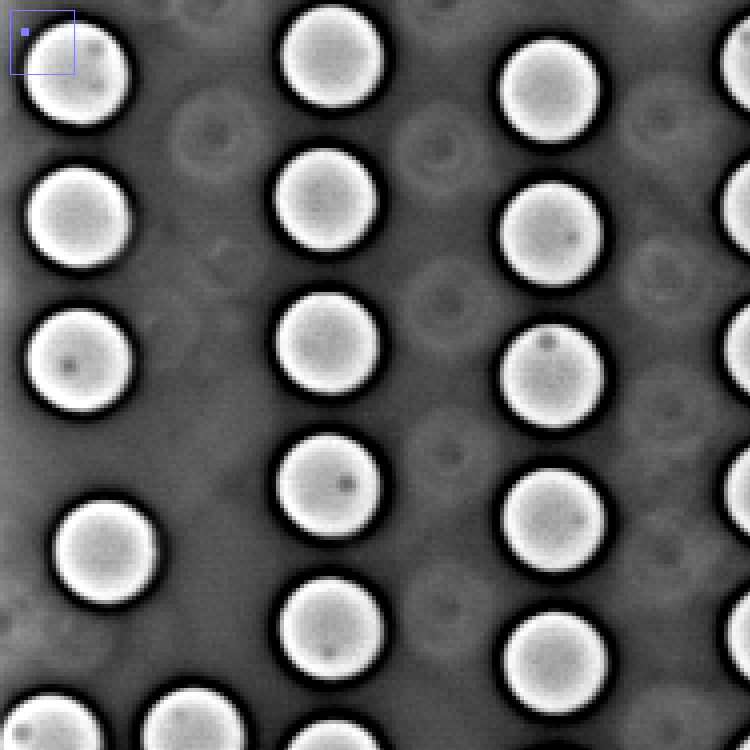
BGA 局部微米级放大

BGA 整体透视视图
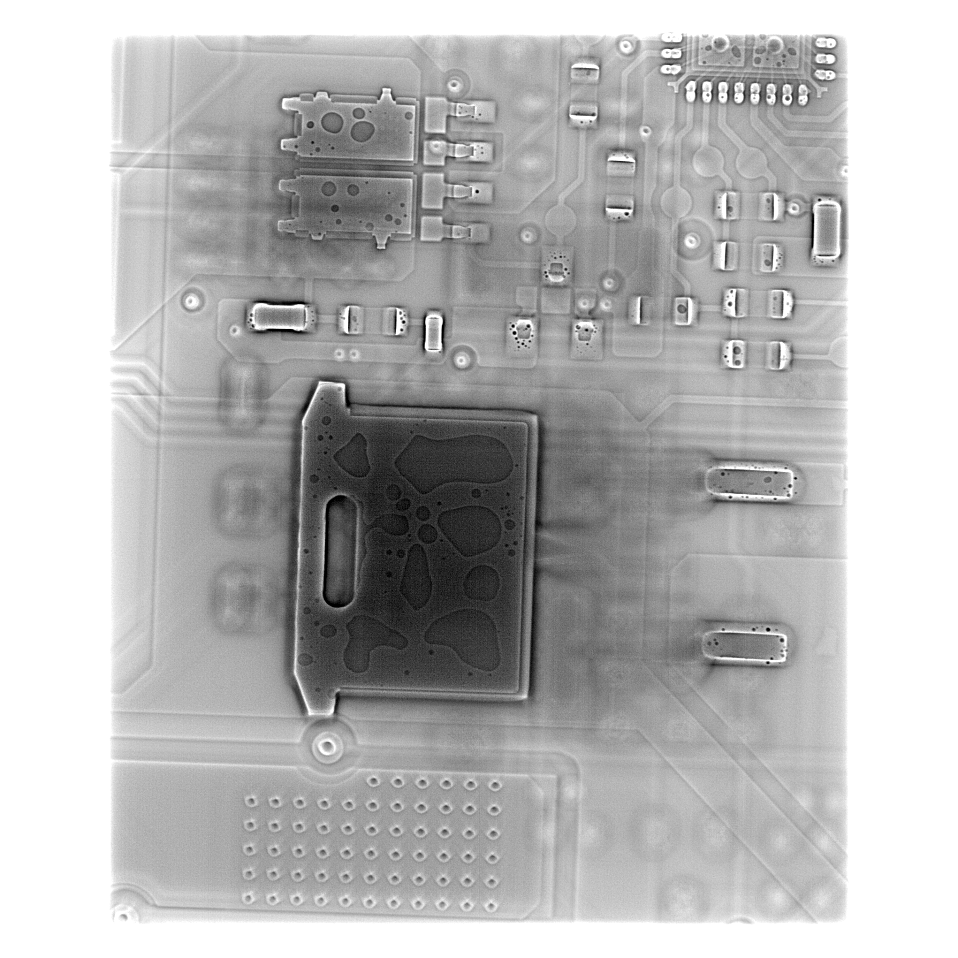
内部气孔着色分析

TGV 通孔缺陷检测
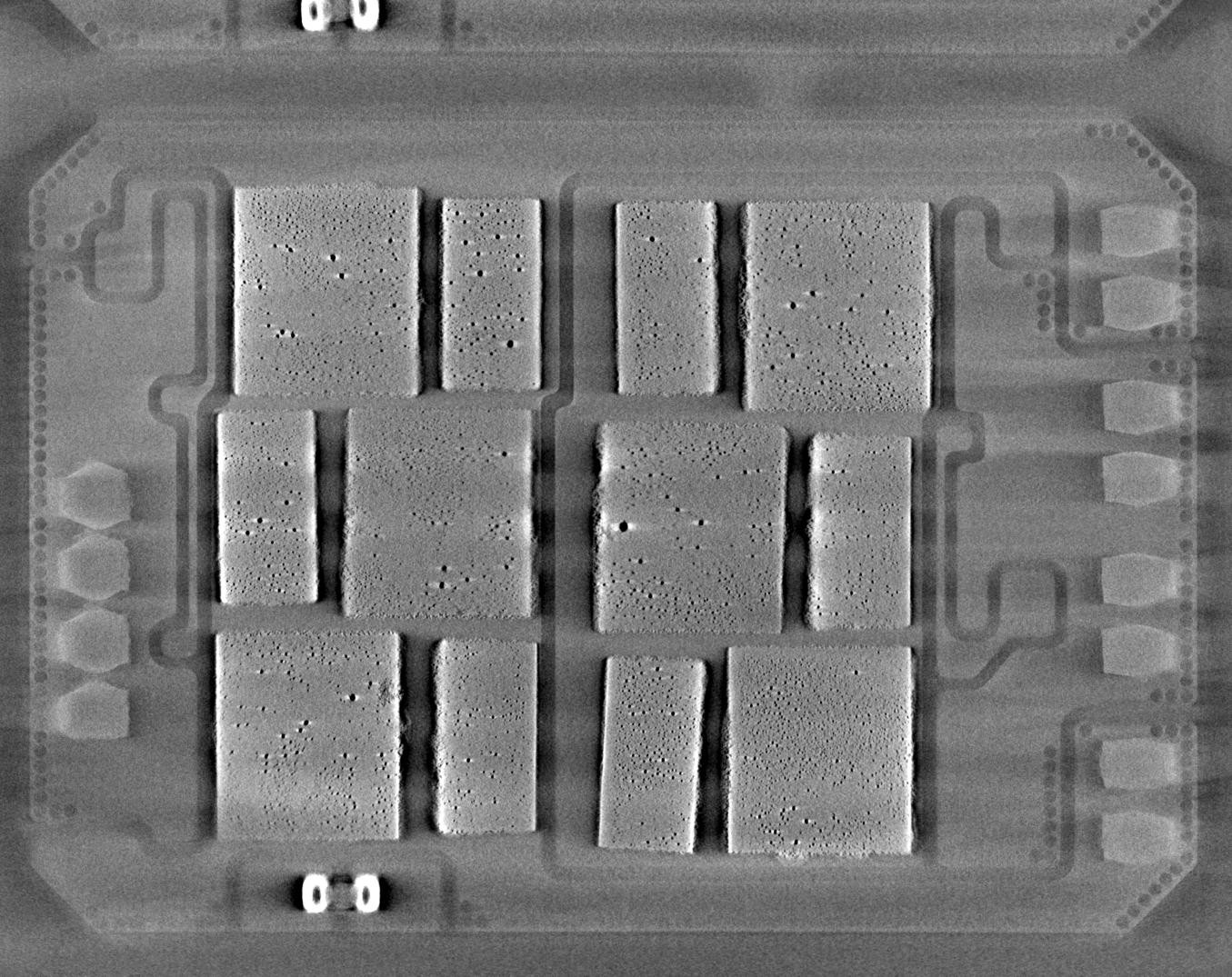
IGBT 功率器件检测

锂电铜极耳翻折

锂电铝极耳开裂
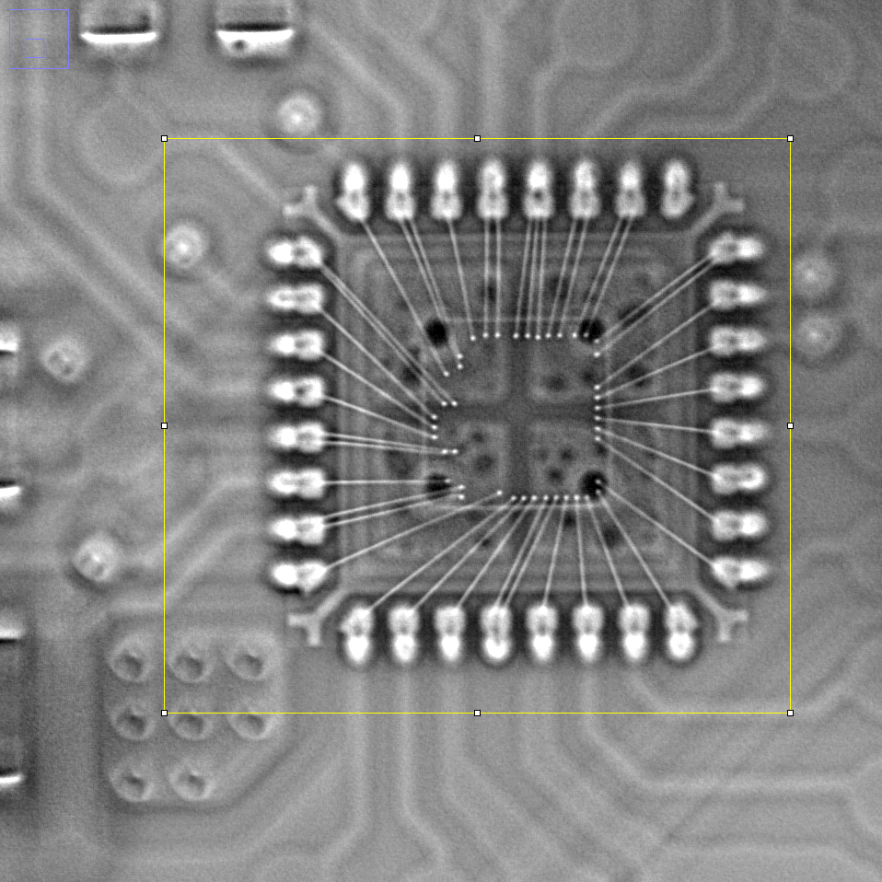
SMT 焊点气孔分析
全3D 自动判别
具备完整的三维成像与自动判别能力,可对焊点及内部结构进行立体分析,提升缺陷识别可靠性。
非破坏式多层切片
无需破坏电路板结构,可任意选择切片层数,实现对内部焊点与堆叠结构的精细观察。
5μm 像素精度
根据元件尺寸与锡球大小灵活设置检测分辨率,最高像素精度可达 5μm,适配多种封装类型。
8μm 系统分辨率
可根据检测需求灵活平衡测试时间与图像清晰度,系统最高分辨率可达 8μm,兼顾效率与质量。
边扫描边重建
采用高速边扫描边重建算法,在扫描过程中同步完成三维数据计算,满足在线检测节拍要求。
118° 大射线锥角
最大 118° 射线锥角设计,有效提升纵向分辨率,适用于 PoP、Flip Chip 等复杂堆叠封装分析。
| 基础规格 | 整机尺寸 | 2150 × 1420 × 1930 mm |
|---|---|---|
| 对接高度 | 900 ± 20 mm | |
| 样品承重 | < 10 kg | |
| 净空要求 | Top: 60 mm;Bottom: 40 mm | |
| 检测对象 | 厚度范围 | 0.6 – 5 mm |
| 兼容尺寸 | 50×50 mm ~ 510×510 mm | |
| X-Ray 系统 | 射线源 | 高精度封闭式射线源 (<150 kV) |
| 辐射安全 | X-Ray 泄露 <0.5 μSv/h | |
| 探测器 | CMOS (2340×2813 矩阵 / 49.8μm 像素) | |
| 性能指标 | 检测精度 | 最高约 5 μm |
| 3D 成像速度 | 最快约 2 s 内 |
回到顶部






 18902978624
18902978624 


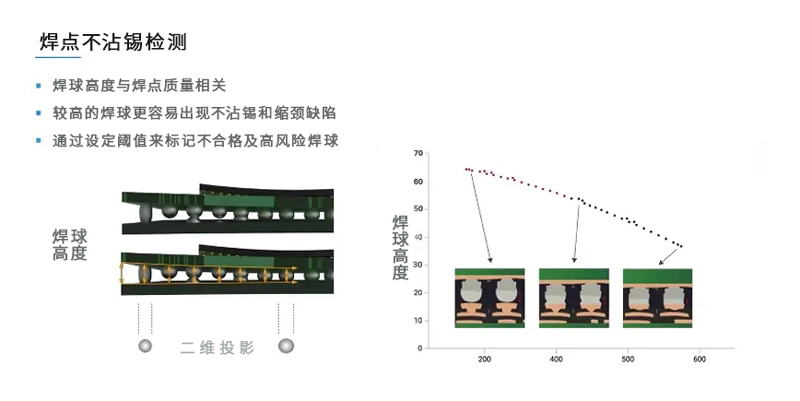





 总部地址:深圳市光明区马田街道星源先进材料产业园3栋7楼
总部地址:深圳市光明区马田街道星源先进材料产业园3栋7楼  袁经理:
袁经理:
