X射线CT检测碳化硅
文章来源:骅飞科技X-Ray 发布时间: 2026-01-06
X射线CT检测碳化硅:实现SiC内部缺陷的三维解析
碳化硅(SiC)晶圆及功率器件制造过程中,裂纹、杂质与孔洞等缺陷往往隐藏于材料内部。 借助X射线检测中的CT技术,可在不破坏样品的前提下实现微米级三维成像分析。
为什么碳化硅检测越来越依赖 X 射线 CT?
传统二维透视难以准确判断缺陷的空间位置与真实尺寸,而X射线CT通过多角度采集与算法重建, 可对碳化硅材料进行“逐层切片”式分析,为可靠性评估提供量化依据。
真正的价值在于:
不是简单判断“有没有缺陷”,而是明确缺陷是否位于关键功能区域,是否会影响器件寿命。
典型碳化硅可检测缺陷类型
X射线CT广泛应用于SiC晶圆、功率模块与封装结构的内部检测, 可识别微裂纹走向、杂质夹杂分布、烧结孔洞以及结构不连续区域。
基于商业信息协议及对知识产权的尊重,此处展示的X射线检测影像仅作技术能力展示之用。骅飞诚挚邀请您携带/邮寄样品,体验设备的实际检测效果。
视频演示:碳化硅 X 射线 CT 实际检测
从检测结果到工程决策支持
通过三维定量分析,检测结果可辅助判断缺陷对电性能与结构可靠性的潜在影响, 为研发优化、来料评估及失效分析提供科学依据。
骅飞科技,工业X-Ray智能检测装备的制造商。
回到顶部








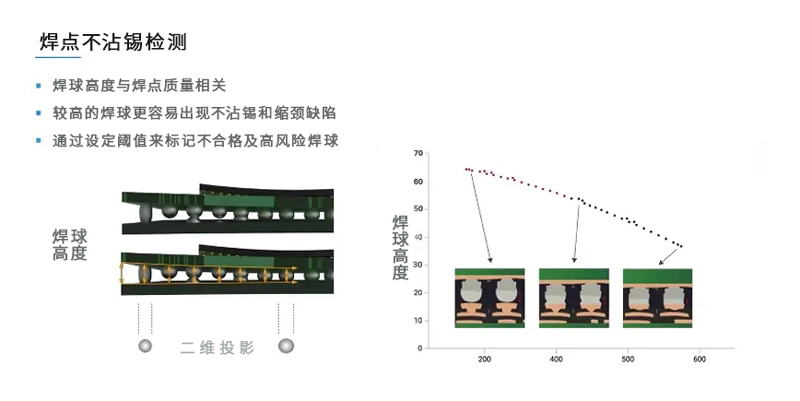





 总部地址:深圳市光明区马田街道星源先进材料产业园3栋7楼
总部地址:深圳市光明区马田街道星源先进材料产业园3栋7楼  袁经理:
袁经理:
